在2025年英特爾代工大會(Intel Foundry Direct)的盛會上,英特爾代工服務(wù)部門的領(lǐng)航者Kevin O'Buckley向與會者揭示了英特爾對于大規(guī)模異構(gòu)集成的宏偉藍(lán)圖。
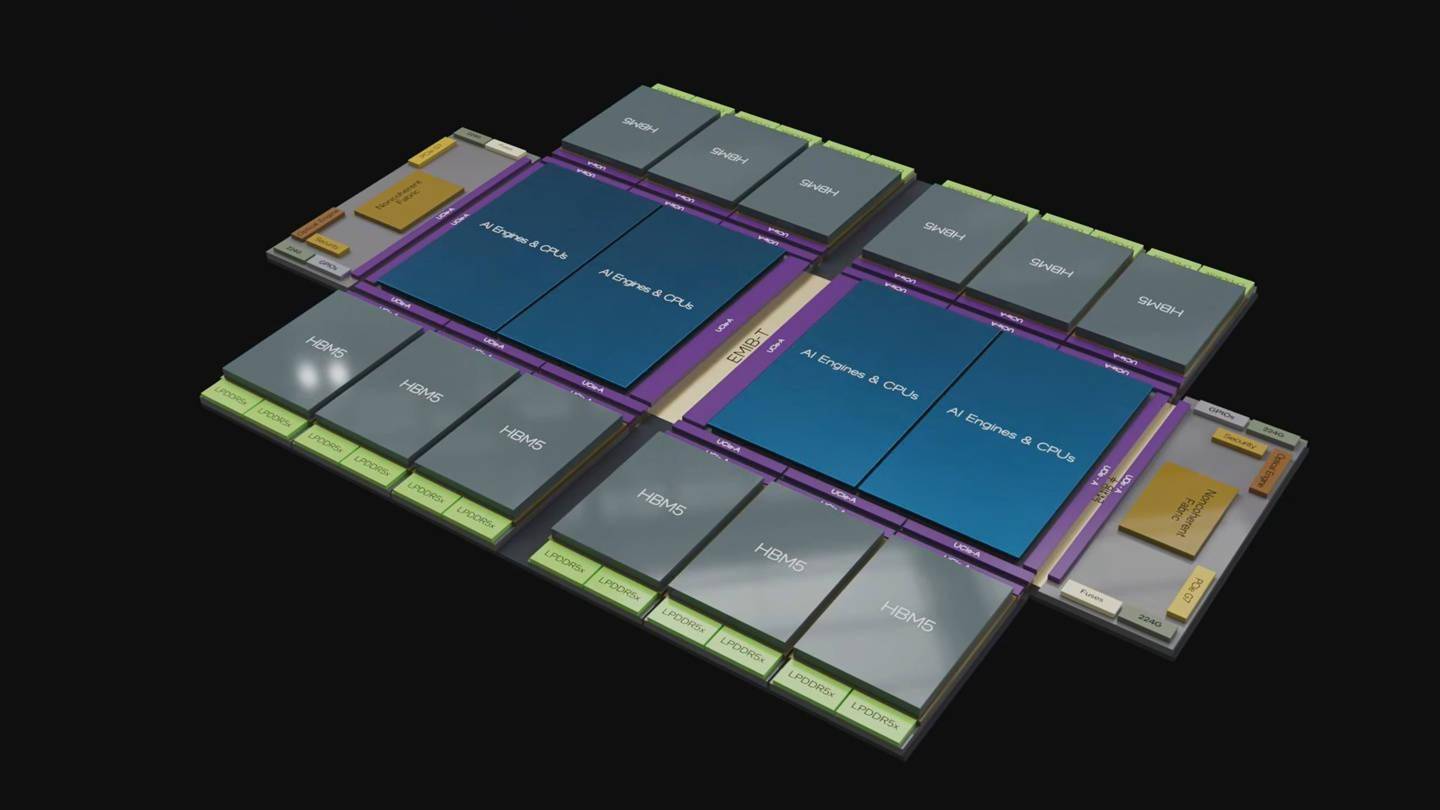
這一創(chuàng)新構(gòu)想中,一個前所未有的芯片復(fù)合體將成為核心,它融合了英特爾的多項尖端制程技術(shù)與高級封裝工藝。具體而言,該復(fù)合體將包含一個基于Intel 18A-P工藝的IO芯片,內(nèi)置224G SerDes和光學(xué)引擎;一個以Intel 18A-PT工藝為基礎(chǔ)的計算核心芯片;以及通過Intel 14A / 14A-E工藝3D垂直堆疊于基礎(chǔ)芯片之上的AI引擎和GPU單元。
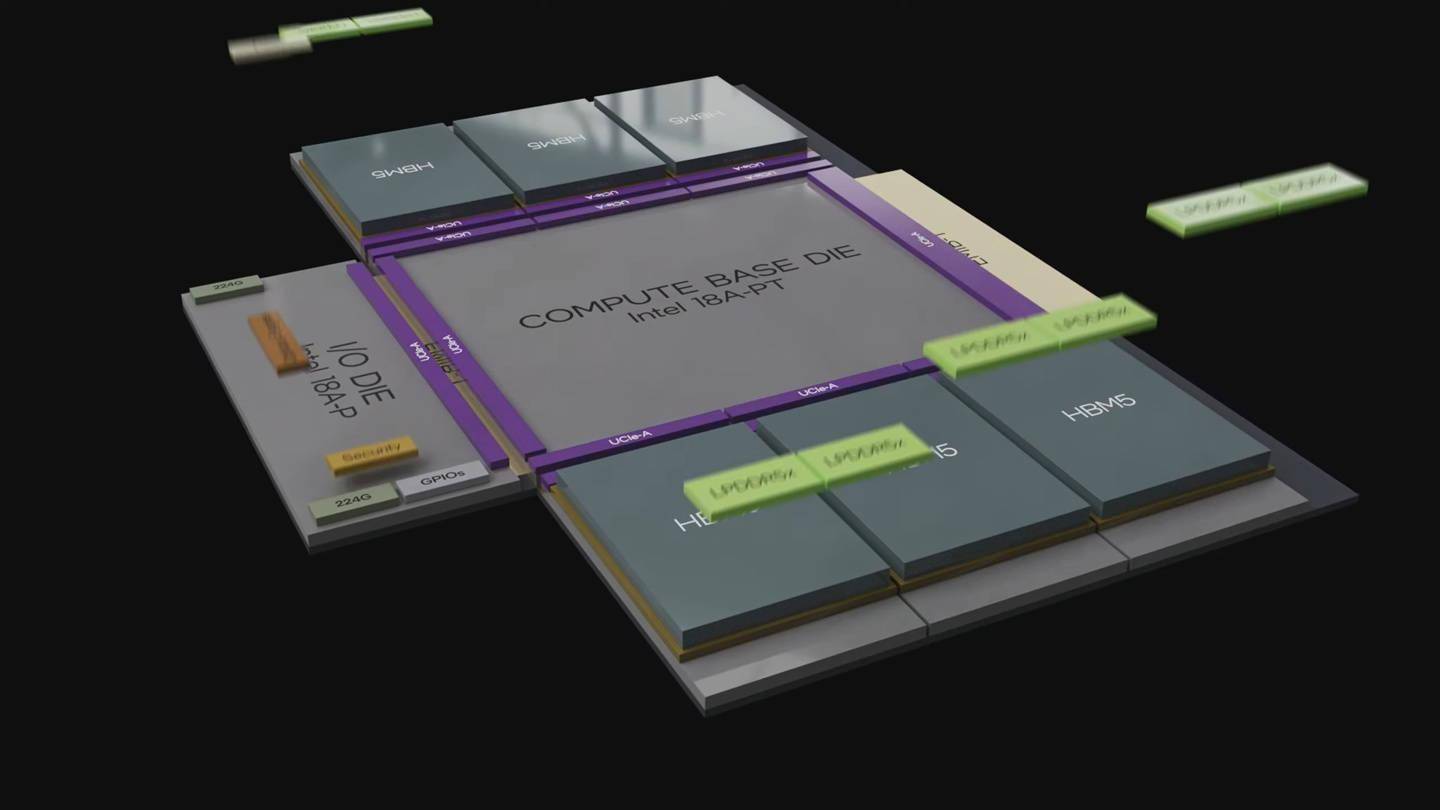
這一復(fù)合體還采用了HBM5 + LPDDR5x的雙層片外緩存結(jié)構(gòu),并通過EMIB-T先進封裝技術(shù),實現(xiàn)了符合UCIe-A規(guī)范的芯粒互聯(lián),進一步提升了其性能與效率。
Kevin O'Buckley在活動現(xiàn)場強調(diào),這一設(shè)想中的復(fù)合體尺寸驚人,超過了12倍的光罩尺寸,而如此規(guī)模的封裝技術(shù)在市場上至少還需等待至2028年才能面世。為了直觀展示這一創(chuàng)新成果,他還向與會者展示了復(fù)合體的概念樣品。

在Kevin O'Buckley的展示中,這一復(fù)合體不僅展現(xiàn)了英特爾在半導(dǎo)體制造技術(shù)上的深厚積累,更預(yù)示著未來芯片設(shè)計與制造的新方向。與會者紛紛對這一創(chuàng)新構(gòu)想表示出濃厚的興趣與期待。

















